Įvadas
Didinant integracijos laipsnį, svarbus yra gretimų integrinių elementų izoliacijos procesas.
Lokalinė silicio oksidacija – storo SiO2 sluoksnio sudarymas – paprastai taikoma MOS/CMOS technologijoje. Termiškai užauginto silicio oksido sluoksnis atskiria gretimas struktūras (PMOS ir NMOS tranzistorius CMOS struktūroje). Formuojant SiO2 sritį, silicio nitridas (Si3N4) naudojamas kaip maskuojantis sluoksnis lokalinės silicio oksidacijos metu
Taikant LOCOS (angl. LOCOS – Local Oxidation of Silicon) technologiją [1], sumažinamos parazitinės nuotėkio srovės, supaprastėja technologinis gamybos procesas (nebereikalingas vienas fotolitografijos etapas), difuzinės santakos ir ištakos sritys atskiriamos lokaliniu oksidu gretimose struktūrose. Kaip LOCOS oksidai panaudojami bipolėje technologijoje, yra nagrinėta [2].
CMOS technologija
CMOS technologijos gamyboje naudojama lokalinė silicio oksidacija, siekiant atskirti puslaidininkinius elementus. LOCOS MOS technologija priskiriama prie kombinuotosios izoliacijos metodų. Galima skirti du CMOS mikroschemų gamybos variantus: pirmasis – kai atliekamas lokalinis oksidavimas, siekiant atskirti gretimus puslaidininkinius elementus; antrasis – kai suformuojamos difuzinės sritys ir atliekamas lokalinis oksidavimas siekiant sudaryti storą silicio oksido sluoksnį virš n+ sričių. Pastaruoju atveju augantis oksidas plečiasi į šonus ir į gylį, atsiranda vietinių įtempių, todėl gali būti iškraipytos jau suformuotos difuzinės sritys.
MOS technologiniame procese užtūrinis dielektrikas yra termiškai užaugintas silicio oksidas. Nuo užtūrinio dielektriko kokybės priklauso pagrindiniai MOS tranzistoriaus parametrai. Šio dielektrinio sluoksnio užterštumas ir defektai sukelia krūvių koncentracijos tūryje ir paviršiuje, pramušimo įtampos, dielektrinės skvarbos ir kitus nestabilumus. Užtūros dielektriko kokybė priklauso nuo plokštelės paviršiaus paruošimo, gamybos technologinės higienos, technologinės įrangos, naudojamų dujų kokybės, sluoksnio formavimo metodo ir kitų veiksnių. Užtūrinio dielektriko formavimas yra paskutinė aukštos temperatūros operacija. Šios operacijos metu nusistovi galutiniai difuzinių pn sandūrų matmenys.
CMOS technologinio proceso trūkumas tas, kad užtūrinis elektrodas uždengia difuzines ištakos ir santakos sritis, gaunamos parazitinės talpos, kurios sumažina IG greitaveiką. Tokia sankloda neišvengiama dėl to, kad kanalo sritis formuojama trimis fotolitografijos procesais. Siekiant pagerinti CMOS struktūros parametrus, reikia iki minimumo sumažinti parazitines talpas: užtūra–ištaka, užtūra–santaka; minimaliai sumažinti difuzinių sričių matmenis; sutrumpinti použtūrinį kanalą; užtūros dielektrikui naudoti didelės pramušimo įtampos ir labai stabilias medžiagas.
LOCOS MOS technologija
LOCOS MOS technologijose naudojamas silicio nitridas kaip maskuojantysis sluoksnis (1 pav.). Tačiau jis sukelia nemažai problemų.

Pašalinus nitrido kaukę, šonuose susidaro labai dideli struktūros įtempiai – 1 GPa.
Kiekvieno izoliacijos metodo esmė – elektriškai izoliuoti gretimus elementus vieną nuo kito (2 pav.). Šiuo atveju galima identifikuoti tris parazitinius ryšius: pirmasis – tarp gretimų elementų to paties tipo laidumo sluoksnyje (2 pav., 1 kelias), 2 – tarp skirtingų laidumų sluoksnių (2 pav., 2 kelias), 3 – tarp elementų, esančių skirtingų laidumų sluoksniuose (2 pav., 3 kelias) [3]. Didžiausi reikalavimai keliami izoliuojančiosioms sritims tarp gretimų laidumų sluoksnių (2 pav., 5 kelias) ir tarp to paties laidumo sluoksnių užtūrinių sričių (2 pav., 4 kelias). CMOS struktūroje didelę reikšmę turi parazitinės talpos.
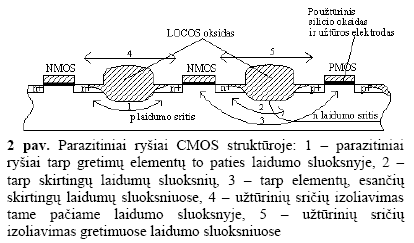
Lokalinio oksido palindimas po nitrido kauke apibūdinamas LOCOS oksido palindimo ilgiu – Loks, μm, ir LOCOS oksido atlenkimo aukščiu – Hoks, μm (3 pav.).

Oksidui palindus po kauke sumažėja kanalo plotis sumažėjimą, nes lokalinės oksidacijos metu formuojant oksidą gali būti perslenkamos ištakos ir santakos sritys po užtūra. LOCOS oksido formą šalia kaukės kraštų lemia:
- Silicio oksido ir silicio nitrido storiai, suformuoti iki lokalinės oksidacijos pradžios;
- Kristalinės gardelės orientacija. <111> silicio padėklų oksidas palenda mažiau nei <100> silicio. Taip pat ji priklauso nuo kaukės orientacijos;
- Oksidacijos temperatūra, trukmė.
Reikalavimai LOCOS CMOS technologijai
LOCOS MOS technologijai keliami šie pagrindiniai reikalavimai: mažinti kanalo ištaka–santaka ilgio praradimus, retinti defektų tankumą, mažinti įtempius.
Lokalinės oksidacijos pagrindinės problemos:
- Geometrinis efektas (užtūrinio kanalo trumpėjimas, įtempiai, defektai);
- 0,2–2,5 μm storio izoliacinis oksidas formuojamas iki aštuoniolikos valandų sausame deguonyje 1000 ºC temperatūroje. Šiomis sąlygomis paslėptojo n+ sluoksnio priemaišos persiskirsto ir prasiskverbia gilyn. Todėl izoliacinį oksidą reikia formuoti oksiduojant H2O garuose. Esant 1000 ºC temperatūrai ir 3*103 Pa garų slėgiui, LOCOS oksidas suformuojamas maždaug per šešias valandas [4];
- Si3N4 sluoksnio cheminė struktūra nereguliari, jame pasitaiko kiaurymių, įtrūkimų, todėl į Si3N4 formavimą būtina atkreipti ypatingą dėmesį;
- Lokalinės oksidacijos metu deguonies molekulės prasiskverbia po maskuojančiuoju Si3N4 sluoksniu, vykstant reakcijoms (Si+O2=SiO2), oksidas palenda po nitrido kauke. Iškilimų aukštis 0,3–0,6 μm, ilgis 2–4 μm. Patys iškilimai pakelia Si3N4, kuriame atsiranda įtrūkimų;
- LOCOS metu gali pasireikšti silicio nitrifikacija, t. y. vandens garų reakcija su sluoksniu, esančiu po nitrido kauke. Procesas pavaizduotas 4 pav.
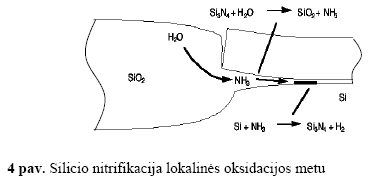
Nitrifikacija pasireiškia užtūrinio kanalo kraštuose. Tokios reakcijos gali vykti tik pašalintos kaukės kraštuose, kur H2O kiekis mažas, bet jo gali užtekti nitrifikacijos reakcijoms įvykti.
LOCOS CMOS technologijos modeliavimas
Silicio oksido augimo procesas modeliuojamas programa SUPREM IV, naudojant paprogramius [5].
Taikomas skaičiavimo algoritmas, pagal kurį apskaičiuojamas oksido augimas atsižvelgiant į esamą Si pagrindą. Šioje programoje oksidas ir nitridas traktuojami kaip klampūs nesuslėgti skysčiai. Lokalinei oksidacijai galima naudoti ir suslėgto skysčio modelį, kuris yra spartesnis ir gerokai tikslesnis, bet plačiau taikomas nesuslėgto klampaus skysčio modelis, nes šiuo atveju galima analizuoti įtempius, atsirandančius struktūroje oksidacijos metu. Oksiduojama vandens garuose [5].
Oksidacijos proceso metu vyksta silicio oksidacija ir po Si3N4 kauke susidaro pašalinė oksidacija. SiO2 tūris yra didesnis nei Si tūris, todėl silicio nitrido kaukės kraštai keliami į viršų (5 pav.).
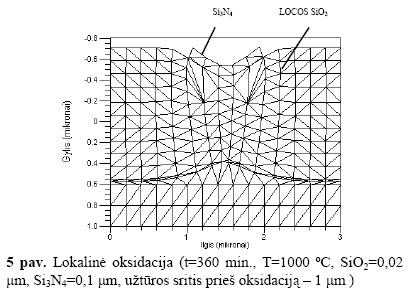
Atsiradus įtempiams, įtrūkimams, gali būti iškraipomi formuojami integriniai elementai, jų parametrai, lokalinės oksidacijos srities forma. Oksidacijos metu pro įtrūkimus gali patekti deguonis.
Prieš lokalinės oksidacijos procesą paliktas 1 μm ilgio kanalas yra deformuotas ir praradęs savo formą bei savybes. Siekiant išvengti tokios dideles deformacijos, kanalas ilginamas iki 3 μm (6 pav.). Gaunamas apie 0,4 μm ilgio nedeformuotas kanalas. Palindimas SiO2 po nitrido kauke siekia 1,3 μm iš kiekvienos pusės.

Lokalinės oksidacijos tyrimas priklausomai nuo proceso technologinių režimų
Oksidacija priklauso nuo trukmės, temperatūros, nitrido kaukės, SiO2 storio.
7 pav. paveiksle parodyta LOCOS profilio priklausomybė nuo proceso trukmės, esant T=1000 ºC. Kai oksidacijos trukmė t=100 min, skiriamasis oksidas būna nepakankamo storio. Šiuo gamybos atveju nitrido struktūroje ir po ja susidaro didesni įtempiai. Norint to išvengti, oksidacijos reakcijos trukmė ilginama iki 400 min (7 pav.). Kad susidarytų pakankamo storio SiO2 sluoksnis, LOCOS turi vykti apie 360 min [4] (6 pav.) ir tokiu atveju, norint gauti reikiamo ilgio nedeformuotą užtūrinį kanalą, reikia jį ilginti prieš oksidaciją iki 3,6 μm.
Toliau programa SUPREM IV atliktas LOCOS oksido modeliavimas esant 900 °C ir 1100 °C temperatūroms. Rezultatai pateikti 8 pav. (modeliavimas esant 1000 °C temperatūrai, pateiktas 6 pav.).
Temperatūra – svarbus LOCOS oksido formavimo technologinis parametras. Atlikus LOCOS modeliavimą minėtomis sąlygomis skirtingose temperatūrose (T=900 °С – 8 pav., a, T=1000 °С – 6 pav., T=1100 °С – 8 pav., b) ir palyginus pateiktas struktūras, galima įsitikinti, kad, pakėlus proceso temperatūrą iki T=1100 ºC, Si3N4 būna labiau pakeltas ten, kur susidarė pašalinis silicio oksidas. Loks padidėja 0,11 μm, t. y. iki 1,41 μm.
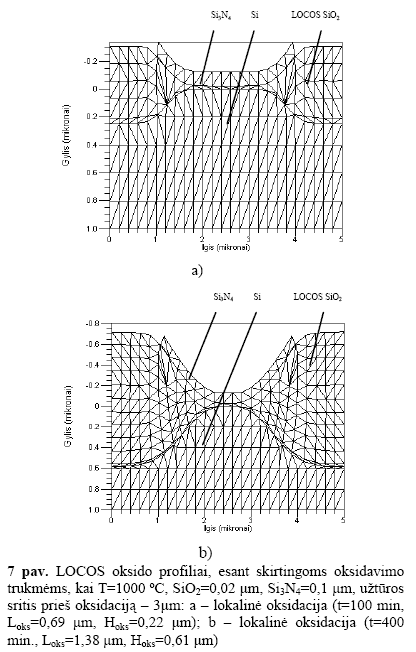
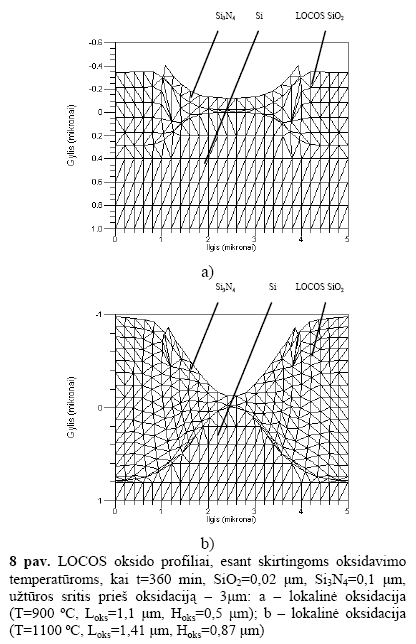
Kai oksidacijos temperatūra T=900 °C užtūrinis kanalas gaunamas ilgesnis, tačiau suformuotas LOCOS SiO2 būna per plonas (CMOS struktūroje gaunamos didesnės parazitinės talpos, didesnės nuotėkio srovės), todėl optimalia laikoma temperatūra T =1000 ºC (6 pav.).
Loks ir Hoks vertėms nustatyti panaudotas modeliavimas programa SUPREM IV, modeliuota esant skirtingiems SiO2 ir Si3N4 storiams. Gauti rezultatai pateikti 9 ir 10 pav.
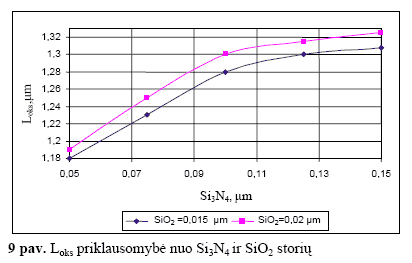
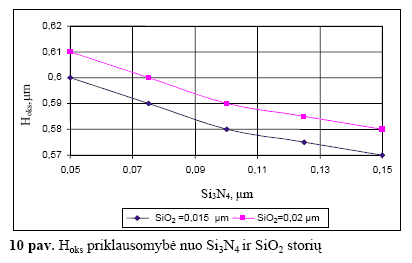
Modeliavimo metu nustatyta, kad, didinant Si3N4 sluoksnį, suformuojamas LOCOS oksidas, kurio Loks didėja, o Hoks mažėja. Taip yra, nes nitrido kaukę veikianti lokalinio oksido augimo jėga nepajėgia atkelti kaukės kraštų ir augantis LOCOS SiO2 slenka gilyn ir mažina kanalo ilgį. Didinant nitrido kaukės storį, deformuojama užtūrinio kanalo sritis bei difuzinės sritys.
Kitu atveju didinant SiO2 storį, suformuojamas didesnio tūrio LOCOS oksidas, Si3N4 yra veikiamas didesnės oksido augimo jėgos, todėl Loks ir Hoks didėja.
Išvados
- Lokalinės oksidacijos metu formuojant storesnį lokalinį oksidą sudaroma didesnė galimybė sumažinti parazitines talpas.
- Prieš oksidavimą palikta 1 μm užtūrinio kanalo sritis LOCOS SiO2 formavimo metu yra užoksiduojama. Norint to išvengti, reikia padidinti kanalo ilgį prieš LOCOS oksidavimą iki ~ 3 μm, mažinti oksidacijos temperatūrą bei trukmę, todėl gaunamas 0,4 μm ilgio kanalas.
- Modeliuojant LOCOS MOS procesą nustatytas optimalus režimas, mažiausiai veikiantis Loks ir Hoks parametrus: trukmė – 360 min; temperatūra – 1000 ºC; SiO2 storis – 0,02 μm; Si3N4 storis – 0,1 μm. Oksiduojama vandens garuose.
Literatūra
- Campbell Stephen A. The Sciences and Engineering of Microelectronic Fabrication. – ISBN 0-19-513605-5. – New York: Oxford University Press, 2001. – P. 68–95.
- Anilionis R., Keršys T. Lokaliojo oksidavimo technologijos kokybės tyrimas // Elektronika ir elektrotechnika. – Kaunas: Technologija, 2004. – Nr. 4(53 ). – P. 46–50.
- Smeys Peter. Local Oxidation Of Silicon for Isolation, PhD Thesis, 2000, Stanford University. ww.stanford.edu/class/ee311/NOTES/isolationSmeys.pdf
- Anilionis R. Elektronikos technologijos. – ISBN 9986-13- 782-9. – Kaunas: Technologija,2000. – P. 144–157.
- SUPREM IV matematinio modeliavimo programa.
R. Anilionis, D. Andriukaitis, T. Keršys. CMOS technologijos, maskuojant silicio nitridu, kokybė // Elektronika ir elektrotechnika. – Kaunas: Technologija, 2005. – Nr. 4(60 ). – P. 73–76.


 Išnagrinėtos lokalinės silicio oksidacijos pagrindinės problemos CMOS struktūroje, susijusios su maskuojančiaisiais sluoksniais, oksidacijos trukme, temperatūra. CMOS struktūros kokybę daugiausia lemia ištakos ir santakos kanalo sutrumpėjimas bei difuzinių sričių persislinkimas LOCOS metu. Programa SUPREM IV atliktas LOCOS CMOS technologinio proceso režimo modeliavimas.
Išnagrinėtos lokalinės silicio oksidacijos pagrindinės problemos CMOS struktūroje, susijusios su maskuojančiaisiais sluoksniais, oksidacijos trukme, temperatūra. CMOS struktūros kokybę daugiausia lemia ištakos ir santakos kanalo sutrumpėjimas bei difuzinių sričių persislinkimas LOCOS metu. Programa SUPREM IV atliktas LOCOS CMOS technologinio proceso režimo modeliavimas.